Какое оборудование электронного машиностроения собираются разрабатывать у нас в России?Часто в комментариях к моим статьям на тему литографов для производства микросхем читатели справедливо писали мне о том, что помимо литографов, для промышленных линий по производству микропроцессоров нужно большое количество и другого оборудования. Народ волновался, что все зациклились на литографах, а другим оборудованием никто не занимается.
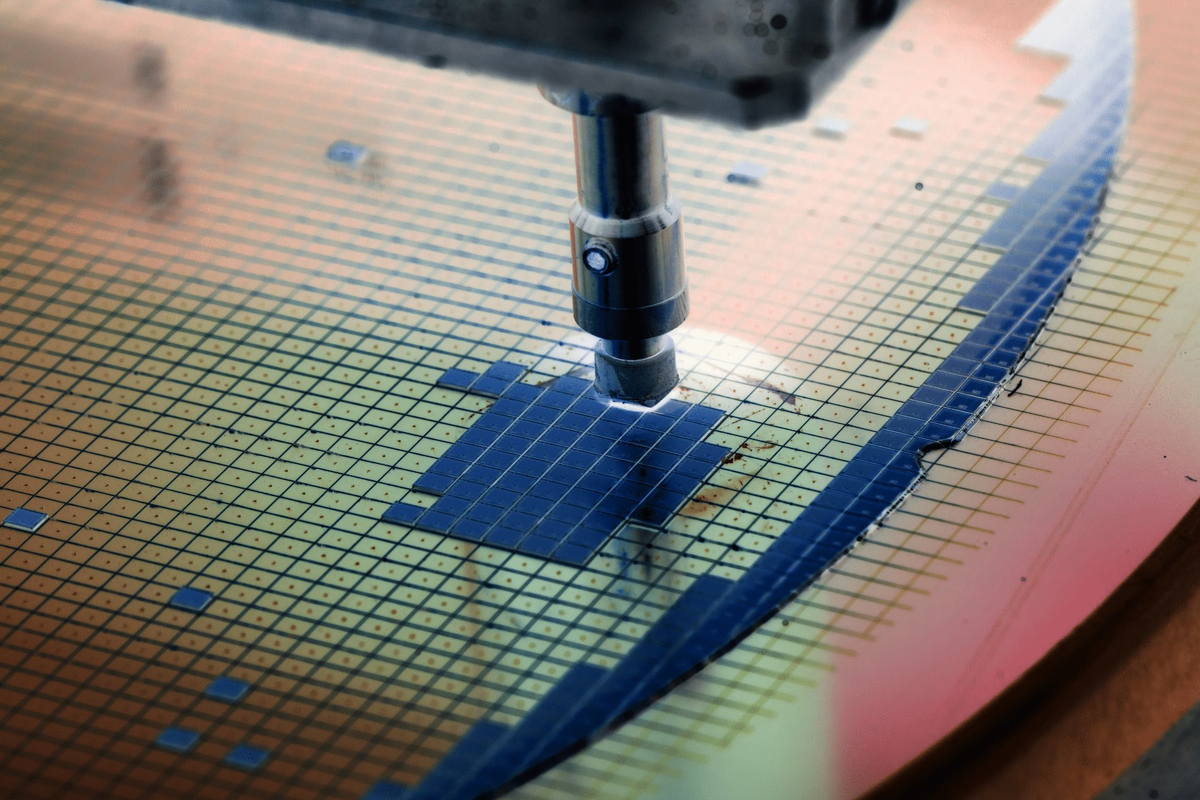
Спешу всех успокоить, занимаются и оборудованием, и материалами, и чистой химией. Как видите, я не раз писал про это тоже.
Более того, ещё летом 2022-го года Минпромторг опубликовал перечень планируемого к разработке специального технологического оборудования для электронного машиностроения. Сегодня хочу поделиться с вами этим списком, он довольно любопытен.
Производство микроэлектроники по проектным нормам 180-130 нм, алюминий, диаметр пластин 200 мм-Установка химико-механической полировки (SiO2, W, Cu)
-Установка осаждения слоев вольфрама методом CVD
-Установка нанесения и проявления DUV (248 нм и 193 нм) фоторезистов
-Установка бесконтактного контроля электрофизических параметров тонких диэлектрических слоёв (вкл. контроль толщины полупроводниковых и диэлектрических слоев)
-Установка контроля дефектности
-Установка контроля процесса ионной имплантации
-Система обнаружения макродефектов в автоматическом режиме для пластин с топологией с возможностью измерения совмещения слоев
-Установка ионной имплантации (среднетоковая) 5KeV-200KeV
-Установка ионной имплантации (высокоэнергетическая) 200 KeV-1000KeV
-Установка жидкостного химического травления обратной стороны
-Установка жидкостного химического травления
-Установка жидкостной химической обработки
-Установка жидкостной обработки SMIF-контейнеров
-Установка визуального контроля (анализ лицевой поверхности пластины в оптическом микроскопе (5/10/50/100/150x), в режимах темного и светлого поля, включая режим анализа пластины в косом свете, в т.ч.с источником глубокого ультрафиолета
-Растровый электронный аналитический микроскоп с рентгенофлуоресцентным спектрометром
-Автоматическая зондовая установка
-Профилометр
Производство микроэлектроники по проектным нормам 65-130 нм, медь, диаметр пластин 200 мм-Установка электролитического покрытия меди и золота
-Установка переукладки и ориентации пластин
-Сканер фотолитографии с длинной волны 193 нм по проектным нормам 90-65 нм
Производство микроэлектроники по проектным нормам 28 нм, медь, диаметр пластин 300 мм-Установка осаждения металлических слоев
-Установка электрохимического осаждение меди с 3 камерами осаждения и 3 камерами отмывки
-Установка химико-механической планаризации
-Установка удаления фоторезиста в плазме
-Установка для процессов травления алюминия и удаления фоторезиста
-Установка для процессов плазменного травления диэлектриков Low-k
-Установка для процессов плазменного травления кремния/поликремния и диэлектрических слоев
-Установка светлопольного/темнопольного поиска дефектов
-Установка быстрого термического окисления при низком давлении с генерацией пара в процессе окисления (О2/Н2/N2) и последующей плазменной нитридизацией (DPN) и постнитридизационным отжигом (PNA)
-Установка для осаждения нитрида кремния из газовой фазы при пониженном давлении
-Установка плазмохимического осаждения барьерного диэлектрического слоя
-Установка для осаждения вольфрама с камерой атомно-слоевого осаждения зародышевого слоя
-Установка для отжига в водороде
-Установка низкотемпературного отжига металла
-Трек нанесения и обработки фоторезиста
-Установка для локальной эпитаксии SiGe с камерой для подготовки поверхности перед эпитаксией
-Установка лазерного отжига для активации примеси
-Установка контроля толщины полупроводниковых и диэлектрических слоев на пластинах 300мм
-Установка жидкостного травления нитрида кремния в ортофосфорной кислоте
-Установка очистки пластин от микрочастиц по маршруту (скруббер)
-Установка для атомно-слоевого осаждения нитрида кремния
-Сканер иммерсионной фотолитографии с длинной волны 193 нм по проектным нормам 45-28 нм
-Рентгеновский литограф 13,6 нм (Примечание: в 2023-м году выбор был сделан в пользу длины волны 11,2 нм).Производство СВЧ-электроники [на GaAs (арсенид галлия) по проектным нормам 150-250-500 нм (76-100мм,150мм), на GaAs/InP (арсенид галлия / фосфид индия) по проектным нормам 150-250 нм (76-100мм) и на GaN/SiC (нитрид галлия / карбид кремния) по проектным нормам 150-250-500 нм (76-100мм)]-Эталоны для калибровки для зондов
-Установка электронно-лучевого напыления с использованием геометрии «lift-off»
-Установка электронно-лучевой литографии (Ø200 мм, 100нм)
-Установка плазмохимического RIE травления и PECVD осаждения на групповую партию пластин Ø100-150мм
-Установка плазмохимического травления и осаждения с цилиндрическим электродом
-Установка МОГФЭ InGaAsSbP 5×Ø100мм или 3×150мм
-Установка молекулярно-лучевой эпитаксии InGaAsSbP на пластинах до 200мм или 3×Ø100мм
-Установка ионно-лучевого травления
-Кластерная установка бондинга/дебондинга (Ø150 мм)
-Установка быстрого термического отжига (производительность до 10 пл в час)
-Установка безмасковой лазерной литографии
-Рентгеновский дифрактометр (минимальный шаг сканирования 0.0001°)
-Модули расширения частотного диапазона для векторных анализаторов цепей и анализаторов спектра
-Модули и узлы для радиочастотных измерительных приборов
Производство СВЧ-электроники на GaN/Si по проектным нормам 150-250-500 нм (100-150мм)-Установка для выращивания монокристаллов Si, в т.ч. высокоомного
Производство СВЧ-электроники на GaAlInSbAs по проектным нормам 150-250 нм (76-100мм,150мм)-Установка молекулярно-лучевой эпитаксии GaAsSb на пластинах 150 мм
Производство фотошаблонов 90-65 нм-Метрологическая станция определения абсолютных координат местоположения топологических элементов
-Установка монтажа пелликла на поверхность фотошаблона
-Установка моделирования процесса переноса и формирования изображения топологического слоя на п/п пластину
-Установка контроля фазы сдвига полутоновых фазосдвигающих фотошаблонов
-Многолучевой лазерный генератор изображения. Лазерный генератор изображения
-Кластерные установки обработки фотошаблонных заготовок
-Измерительный автоматизированный электронный микроскоп
Производство силовой электроники на Si (150 мм) и на GaN (150 мм)-Установка для утонения пластин
-Измерительная система для контроля высоковольтных транзисторов и диодов
Производство силовой электроники на SiC (150 мм)-Оборудование для высокотемпературного термического окисления SiC и Si
-Диффузионное оборудование для высокотемпературной активации примеси
-Установка газофазной эпитаксии SiC/SiC на пластинах 150 мм
Производство микроэлектромеханических систем (болометр)-Установка переноса меток совмещения
-Установка мегазвуковой отмывки и совмещения пластин
Производство интегральной фотоники на Si-Кластерная установка травления и осаждения слоев SiO2, SiON, Ge-SiON
Производство фотоприемных устройств (QWIP AlGaAs/GaAs, 76-100мм,150мм; xBn,76мм,100мм, 150мм; T2SL,76мм,100мм; InAsSbP/InAs, 76мм,100мм; CdHgTe/CdHgTe 76мм; CdHgTe/Si 100-150мм)-Установка молекулярно-лучевой эпитаксии CdHgTe
Производство фотоники на базе материалов А3В5-Установка для одно- и двухстороннего шлифования и полировки пластин монокристаллов
-Установка субмикронной двусторонней очистки
-Установка скрайбирования и разделения пластин
Заключение
Всё вышеперечисленное оборудование, скорее всего, собираются разрабатывать, раз уж этот список уже разослали потенциальным разработчикам.
https://mtcmr.ru/images/data/g ... -(11l).pdf
Что-то из списка уже делается, вижу знакомые названия ОКР'ов, остальное в планах. Так что нет, про это всё тоже не забыли. Просто СМИ чаще всего следит за ключевым оборудованием производственной фотолитографической линии, а это именно фотолитограф, хотя и без остального оборудования тоже, конечно, не обойтись.
Исходя из вышеприведённого перечня прослеживаются планы по фотолитографии вплоть до 28 нм, причём как с помощью рентгеновской литографии (что сегодня уже не является новостью), так и с помощью иммерсионной фотолитографии с длинной волны 193 нм по проектным нормам 45-28 нм (а вот эту информацию я увидел впервые).
Таким образом, подытоживая, из известного: у нас сегодня в разработке первый из линейки рентгеновских (т.е EUV) литографов для 90-28-16-12 нм и DUV-литографы на 350 и 130 нм с перспективой разработки DUV-литографов на 90 и 65 нм. Кроме того, видимо, есть мысли по иммерсионной (с жидкой средой вместо воздушного зазора с показателем преломления больше единицы) литографии по техпроцессу 45-28 нм.
https://dzen.ru/a/ZlEA36xMLGhmuc4a


















