Характеристики первого российского литографа на 350 нм, проходящего испытания в ЗеленоградеНа днях прошла информация
https://dzen.ru/a/Zk5RKCkpgC7AgKlq о том, что российский литограф для техпроцесса 350 нм уже создан в железе и проходит испытания в составе технологической линейки в Зеленограде.
Кстати, оборудование с похожими по разрешению характеристиками уже имеется в Беларуси аж с 2017 года. Это автоматическая установка совмещения и экспонирования ЭМ-5784:
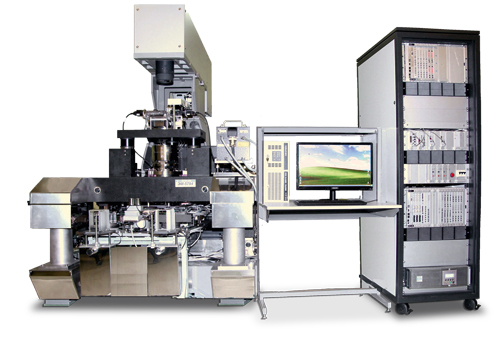 Автоматическая установка совмещения и экспонирования ЭМ-5784 (Беларусь, 2017 год) с разрешением (минимальным размером элемента) 350 нм.
Автоматическая установка совмещения и экспонирования ЭМ-5784 (Беларусь, 2017 год) с разрешением (минимальным размером элемента) 350 нм.Правда, у неё существенно меньше (более, чем на полтора порядка) площадь рабочего поля — 3,2х3,2 мм против 22х22 мм у российского и на ступень меньше максимальный диаметр пластин — 150 мм против 200 мм.
Кстати, в 2021 году эта установка была доработана и по площади рабочего поля и по диаметру пластин, получила название ЭМ-5884, и теперь фактически имеет целевые параметры будущего российского литографа. Так что, возможно, стоимость 1 млрд — это не столько стоимость разработки, сколько стоимость выкупа у белорусов всех технологий и лицензий на этот литограф для создания своего варианта? :-)
Поскольку известно, что разработка российского литографа ведётся с привлечением специалистов Планара, то, скорее всего, за основу взят именно ЭМ-5884. Ну, хоть не с нуля начали, уже хорошо.
Замечу, что СССР закончил совершенствование своих литографов на уровне 500 нм. И делали их именно на Планаре! На территории России литографы такого уровня при СССР не производились.Немного смущает то, что в качестве источника излучения в российском литографе значится длина волны 365 нм (это длина волны ртутной лампы), в то время, как в белорусском это 354,7 нм (твёрдотельный лазер, т.е. существенно меньшая потребляемая мощность, повышенная выходная мощность, высокая долговечность и узкий спектр). В то же время мне неизвестно, каков на сегодняшний день процент иностранных узлов в белорусском литографе. Возможно, лазер иностранный, и разрабатывать его с нуля под уже столь зрелый техпроцесс не имеет большого смысла.
В указанной по ссылке выше статье я упоминал сроки выполнения различных этапов работ. В этой же статье я хочу сфокусироваться на общем списке проводимых работ и поподробнее остановиться на технических характеристиках создаваемой установки. Близким к теме людям они будут довольно интересны. Кое что я даже выделил жирным шрифтом.
Более подробно обо всём этом можно прочитать в конкурсной документации по ссылке, приведённой ниже.
Проводимые работыСогласно ОКР
https://www.roseltorg.ru/proce ... 00160 , АО «Зеленоградский нанотехнологический центр» (ЗНТЦ
https://zntc.ru/ ) в сотрудничестве с ОАО «Планар»
http://kb-omo.by/ проводит следующие работы по литографу:
Разработка конструкторской документации с литерой «О» и изготовление опытного образца
установки совмещения и проекционного экспонирования (установки далее - Установки) полупроводниковых пластин, разработка и постановка базовых технологических процессов (далее — БТП) проекционного переноса изображений на пластину (Step&Repeat) с размером минимального конструкционного элемента
350 нм.
Установка предназначена для проекционного переноса изображения фотошаблона на полупроводниковую пластину и мультипликации его на пластине при изготовлении СБИС с проектной топологической нормой 0,35 мкм (350 нм).
В ходе выполнения работы должны быть выполнены следующие работы:
-разработаны составные части эскизных проектов установки;
-разработаны составные части технических проектов;
-изготовлены макеты ключевых узлов установки;
-разработана конструкторская документация (КД), технологическая документация (ТД), проектная документация (ПД) и эксплуатационная документация (ЭД) на установки;
-изготовлен опытный образец установки;-сформированы технические требования (далее — ТТ) к БТП
на основе критического анализа развития технологии современных ЭКБ;
-исследованы и отработаны БТП с использованием разработанных и изготовленных тестовых структур на пластинах диаметром 150 мм на опытном образце установки;
-совместно с Заказчиком проведены предварительные испытания (ПрИ) опытных образцов установки;
-совместно с Заказчиком проведены приемочные испытания (ПИ) опытных образцов установки, по результатам ПИ КД, ТД присвоены литеры «О»;
-получено заключение предприятия-потребителя по уровню параметров и применяемости разработанных установки;
-определено предприятие-изготовитель установки.
Технические требования к изделиюВ состав установки должны входить следующие составные части:
а) устройство оптико-механическое (ОМУ) — 2000 х 2600 х 2500 мм;
б) комплекс управляющий (КУ) — 2000 х 800 х 1600 мм;
в) программное обеспечение;
г) комплект запасных частей и принадлежностей.
ОМУ должно содержать:
а) объектив;
б) систему освещения;
в) систему фокусировки и покадрового выравнивания;
г) систему совмещения;
д) координатную систему;
е) систему загрузки пластин;
ж) систему загрузки фотошаблонов.
КУ должен содержать:
а) стойку управления;
б) вычислительный комплекс, предназначенный для управления установкой и обработки информации, на базе персонального компьютера, имеющей выход в локальную сеть Ethernet.
Ориентировочная масса установки — 3500 кг.
Установка должна производить индивидуальную обработку пластин с
автоматической системой загрузки и выгрузки пластин из подающей кассеты в приемную или из приёмной обратно в подающую.
Установка должна быть оборудована не менее, чем двумя кассетами для загрузки и выгрузки пластин соответственно
диаметром 150 или 200 мм. Вместимость кассет — 25 пластин.Основные технические требования к параметрам составных частей и систем установкиОбъектив
-Рабочая длина волны, нм — 365.
-Масштаб изображения — 1:5 (0,2).
-Диапазон изменения масштаба — ±1х10^-6.
-Погрешность изменения масштаба не более — ±0,5х10^-6.
-Числовая апертура — 0,45 - 0,6.
-Размеры поля изображения, X x Y, мм — 22 х 22.
-Глубина резкости, мкм, не менее для L/S — 0,6.
-Дисторсия (по всему полю изображения), yм, не более — ±0,45.
-Размер минимального элемента по полю изображения периодической структуры в однослойном резисте толщиной 0,98-1,1 мкм с допуском на размер ±10%, мкм — 0,35.
Система освещения
-Максимальная энергетическая освещенность в плоскости экспонирования, мВт/см2, не менее (круговое освещение) — 1100
-Неравномерность освещенности поля изображения, %, не более (при круговом освещении) — ±1,5
-Нестабильность дозы экспонирования, %, не более — ±1,0
Система фокусировки и покадрового выравнивания
-Система должна обеспечить работу при максимально допустимом изменении толщины пластин от партии к партии, мкм, не более — 50.
-Диапазон фокусировки, мкм — 0 - 100.
-Невоспроизводимость фокусировки, мкм, не более — ±0,15.
Система совмещения
-Метки совмещения — дифракционно-фазовые.
-Случайная составляющая погрешности совмещения (3σ), нм, не более — 90
Система загрузки пластин
-Диаметр обрабатываемых пластин, мм — 150 или 200.
-Время переналадки, ч, не более — 12.
-Механизмы загрузки и разгрузки пластин — SMIF-контейнеры.
-Манипулирование пластинами — «рукой» миниробота с вакуумной присоской с обратной стороны пластины.
-Геометрические характеристики кремниевых пластин должны соответствовать требованиям стандартов SEMI, в т.ч. по параметру локальной неплоскостности (методика SBIR), (на поле 22 х 22 мм), мкм, не более — 0,1.
Система загрузки фотошаблонов
-Размер фотошаблонов, мм — 152 х 152.
-Толщина стекла фотошаблона, мм — 6,3 ±0,2
-Высота рамки пелликлов на фотошаблонах, мм, не более — 8,0
-Загрузка подготовленных фотошаблонов с пелликлами — из переносных индивидуальных контейнеров.
-Загрузка фотошаблонов в ОМУ — из магазина фотошаблонов на 12 позиций
-Время смены и позиционирования фотошаблона, с, не более — 50
-Шторки диафрагмы должны обеспечивать положение границ кадра в плоскости фотошаблона с погрешностью, мкм, не более — ±50
Координатный стол
-Рабочий ход, мм, Х — 250, Y — 210.
-Точность позиционирования, нм — ±5
-Масса каретки, кг — 20
-Тип двигателей — линейный
Требования надёжности:-наработка на отказ — не менее 500 часов;
-время восстановления — не более 2 часов;
-срок сохраняемости — не менее 1 года;
-срок службы — не менее 5 лет.
Заключение
Итак, опытный образец литографа уже сделан в железе, проходит испытания, и к концу этого года можно будет запускать его производство в серию. Объём производства, очевидно, будет зависеть от потребностей фабрик, а они определяются спросом на СБИС с техпроцессом 350 нм, который, надо заметить, довольно велик. Ведь помимо топовых микропроцессоров для компьютеров и смартфонов существует огромное количество микросхем для обычной радиоэлектроники, как пример, автомобильной (различные контроллеры работы двигателя и других систем).
Если серийное производство литографов начнётся в 2025-м году, то производственный линии выпустят первые чипы, надо полагать, в 2026-м году. Так что ждём и надеемся :-)
https://dzen.ru/a/Zk-L6jmPFX31 ... ct%5D























